
- Argon
- Oxygen
- Nitrogen

NOTE! The chamber lid is quite heavy, keep all objects such as hands, fingers, tools etc. away from the chamber area, especially when closing the chamber.




Responsible: Anders Liljeborg

|
Welcome to the Reactive Ion Etch facility at the Nanofabrication Laboratory
at KTH, Stockholm. Currently the system is equipped with three process gases:
|

|
The chamber is opened by a lifting cylinder powered by
compressed air. The operation is controlled by the front panel
buttons.
NOTE! The chamber lid is quite heavy, keep all objects such as hands, fingers, tools etc. away from the chamber area, especially when closing the chamber. |

| The system is completely computer controlled. All parameters such as duration, pressure, gas flow, RIE RF power, ICP RF power are controlled via different computer dialogs. Processes are easily put into complete recipes for more or less automatic runs. |

| The plasma can be observed through the small window. Here it is an argon plasma that is active. |

| Here is the oxygen plasma activated. |

| The oxygen plasma activated with both RIE and ICP. The ICP ceramic tube can be seen glowing through the mesh of the top cover. |


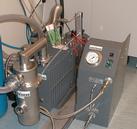

Anders Liljeborg, Nanostructure Physics, KTH.