Product Information - Negative Tone Photoresist Series ma-N 2400 - E-Beam and Deep UV Sensitive
Corresponding processing chemicals
- Developer: ma-D 525 NEW
- Thinner: ma-T 1047
- Remover: ma-R 660
Unique Features
- High wet and dry etch resistance
- Good thermal stability
- Excellent pattern resolution
- Aqueous alkaline development
- Resists available in a variety of viscosities
Applications
- Mask for etching, e.g. for Si, SiO2, metals and semiconductors
- Suitable for implantation
- Use in micro- and nanoelectronics
Technical Data
| Resist | µm | ma-N 2403 | ma-N 2405 | ma-N 2410 | ||
| Film thickness | µm | 0.3 | 0.5 | 1.0 | ||
| Spin coating | rpm |
3000 |
||||
| Spin time | s |
30 |
||||
| Pattern resolution | E-beam Deep UV |
nm nm |
50 200 |
100 300 |
150 500 |
|
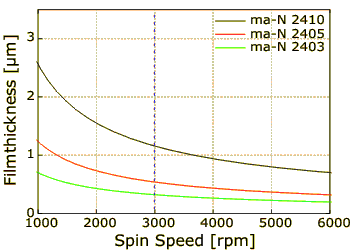 |
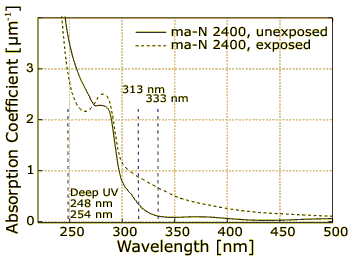 |
ma-N 2400 is well suited for E-beam exposure
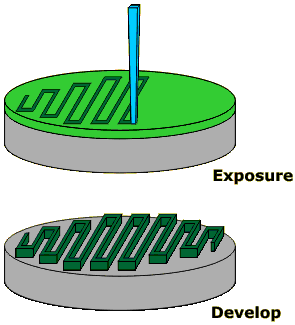 |
Examples
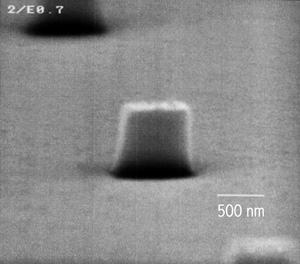 |
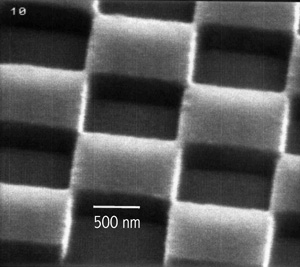 |
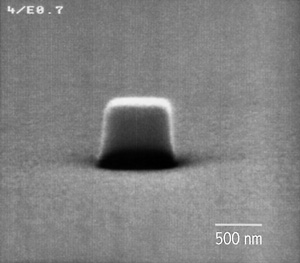 |
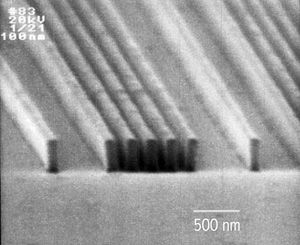 |
 |
 |
Development
ma-N 2400 is developed in aqueous alkaline
solutions. ma-D 525
NEW
(metal ion free) by micro
resist technology GmbH is provided for this
process.
Removal
ma-N 2400 can be removed residue-free after the
micro-technological fabrication process.
We recommend our removers mr-Rem 660 and
mr-Rem 404 s.
Environmental and health protection
All harmful organic solvents in resist and developer have been substituted by safer solvents.