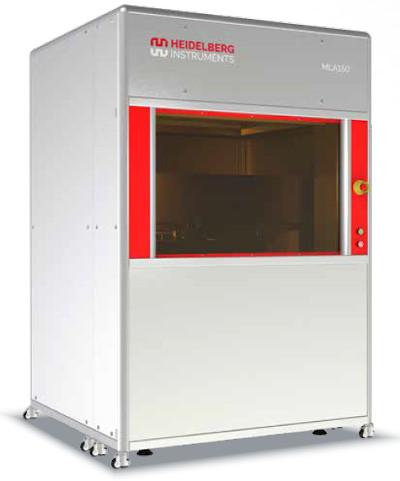
|
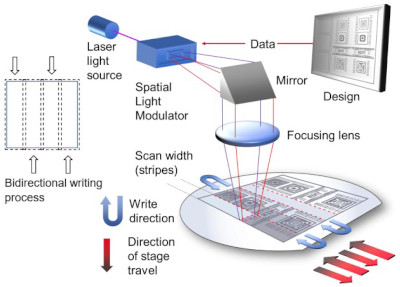
|
| MLA150 with sound proofing and temperature controlled cover | Working principle |
|
Manufacturers fact sheet Manufacturers Manuals limited access Benchmark report, test patterns designed at Albanova, exposed at Heidelberg Inst. site. Limited access. Final Acceptance Test presentation, performed after installation at Albanova Nanolab. Limited access. Shape of alignment marks is very important, please use this example: alignment_marks.zip, zipped GDSII-file. Standard crosses in layer one, inverted (negative) in layer two. Training video, zoom session restricted access.
|
|